摘要
随着晶圆级扇出封装、TSV互连及精密Bump键合工艺高速发展,芯片封装朝着微型化、高密度、高精度集成方向快速升级。晶圆级Bump键合作为芯片互连的核心工序,凸点键合平整度、高度均匀性及表面三维轮廓精度,直接影响晶圆对位贴合良率、键合强度及芯片后续通电导热稳定性。传统接触式测量易划伤晶圆键合面及微细凸点结构,常规二维光学检测仅能获取平面尺寸数据,无法量化三维形貌形变与键合面微观起伏,难以满足晶圆级批量键合工艺的高精度质控严苛要求。本文依托白光干涉测量核心技术,结合晶圆级封装专属工况特性,定制化搭建Bump键合专用3D轮廓测量方案,实现键合凸点及晶圆接触面无损、高效、精密三维检测,适配晶圆级封装研发调试与量产全流程质控应用。
1 测量技术核心原理及工艺适配优势
白光干涉仪基于宽光谱低相干干涉光学原理,搭配高精度压电扫描驱动组件与高清成像采集系统,通过采集晶圆Bump表面不同纵向高度的干涉光场信号,依托专业数据分析算法精准重构完整三维立体轮廓模型。该测量方式全程非接触式无损探测,无机械接触施压,可完好保护晶圆超薄基材与微细键合凸点,杜绝检测过程造成的结构损伤与形变问题。相较于激光单点测量设备,白光干涉测量具备纵向纳米级超高分辨率、无光斑衍射干扰、全域成像扫描的显著优势,可精准捕捉Bump键合后细微塌陷、边缘形变、表面微观凹凸等隐性缺陷。同时优化光学观测倍率与全域扫描逻辑,兼顾实验室工艺研发高精度检测需求与产线晶圆批量快速检测效率,适配不同规格晶圆级封装量产场景。
2 关键测量指标与方案实际应用设计
本专项测量方案紧扣晶圆级封装Bump键合核心质控指标,可一键自动化检测键合凸点有效高度、整体阵列共面度、键合面平整度、凸合塌陷形变程度、阵列位置偏移量及微观表面粗糙度等关键参数,同步生成直观可视化3D轮廓模型与二维截面分析报表。方案兼容各类尺寸晶圆及不同材质键合凸点检测,搭载自动晶圆对位、阵列智能识别、批量连续扫描及数据自动归档功能,有效规避人工定位与测量带来的操作误差。可全面覆盖键合前凸点预处理检测、键合后成品形貌核验全工序,精准筛查凸点缺失、偏移不均、键合虚接、形貌异常等工艺不良问题,为晶圆级封装工艺参数优化、制程稳定性管控、不良品前置拦截提供可靠量化数据支撑。新启航 专业提供综合光学3D测量方案
大视野3D白光干涉仪——微透镜纳米级测量解决方案
突破传统测量局限,定义微透镜及光学元件检测新范式!大视野3D白光干涉仪凭借核心创新技术,实现纳米级全场景测量,以高效、精密的优势,适配微透镜、DOE衍射光学元件等各类光学部件检测需求,重新诠释精密测量的核心标准。
核心优势:大视野+高精度,打破行业技术壁垒
打破行业常规局限,彻底解决传统设备1倍以下物镜仅能单孔使用、需两台仪器分别实现大视野与高精度测量的痛点。设备搭载全新0.6倍轻量化镜头,配备15mm超大单幅视野,搭配可兼容4个物镜的转塔鼻轮,一台设备即可全面覆盖大视野观测与高精度测量需求,无需频繁切换设备,大幅提升检测效率与数据精准度,完美适配微透镜等复杂光学样品的测量场景。

核心测量能力及实测应用
(图示为新启航实测光学元件关键指标:含平面度误差、PV值、RMS值,精准把控光学元件平面精度,为微透镜等部件的性能保障提供可靠支撑)

(图示为新启航实测表面粗糙度,精度达6pm=0.006nm,精准表征微透镜表面光滑度,满足高精度光学部件检测需求)
特色能力1:80度倾斜测量,突破平面测量局限
打破“白光干涉仅能测平面”的行业认知,凭借领先的高角度测量技术,可轻松应对80°陡峭斜面、锥面测量,兼容度拉满,一台设备即可搞定各类复杂角度光学部件检测,无需额外配备专用测量仪器。
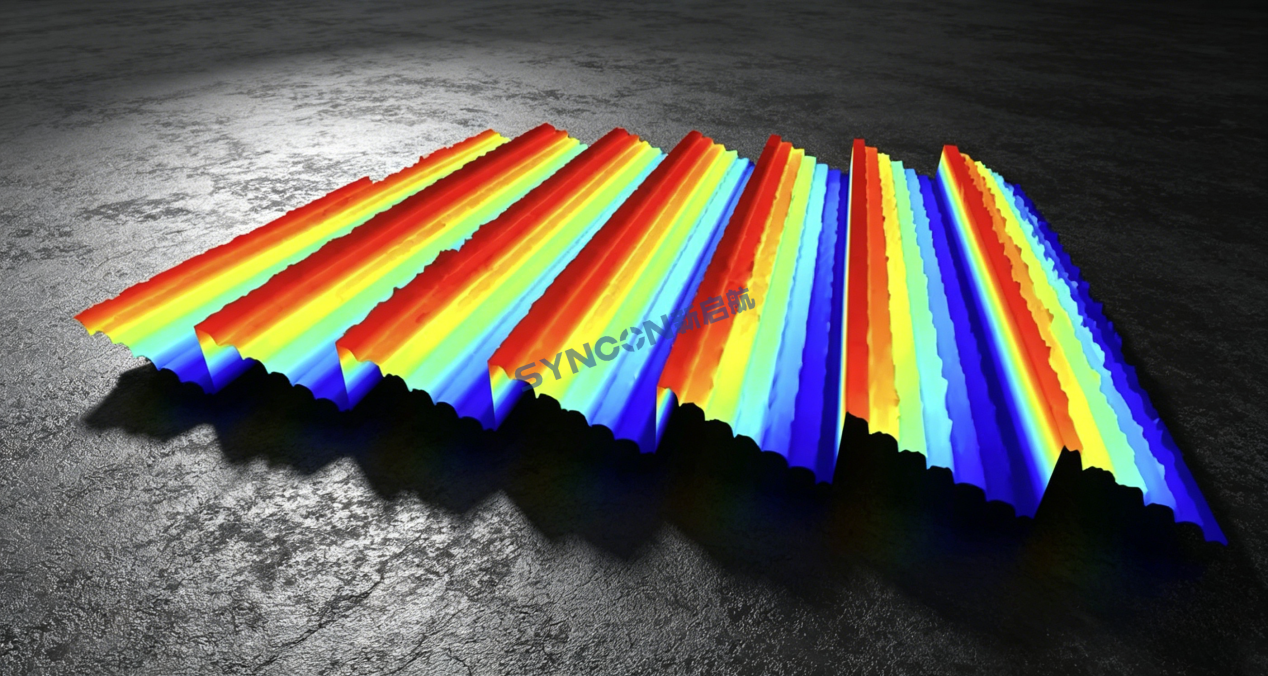
(图示为DOE衍射光学元件结构图,清晰呈现元件微观结构,助力衍射光学元件质量管控)
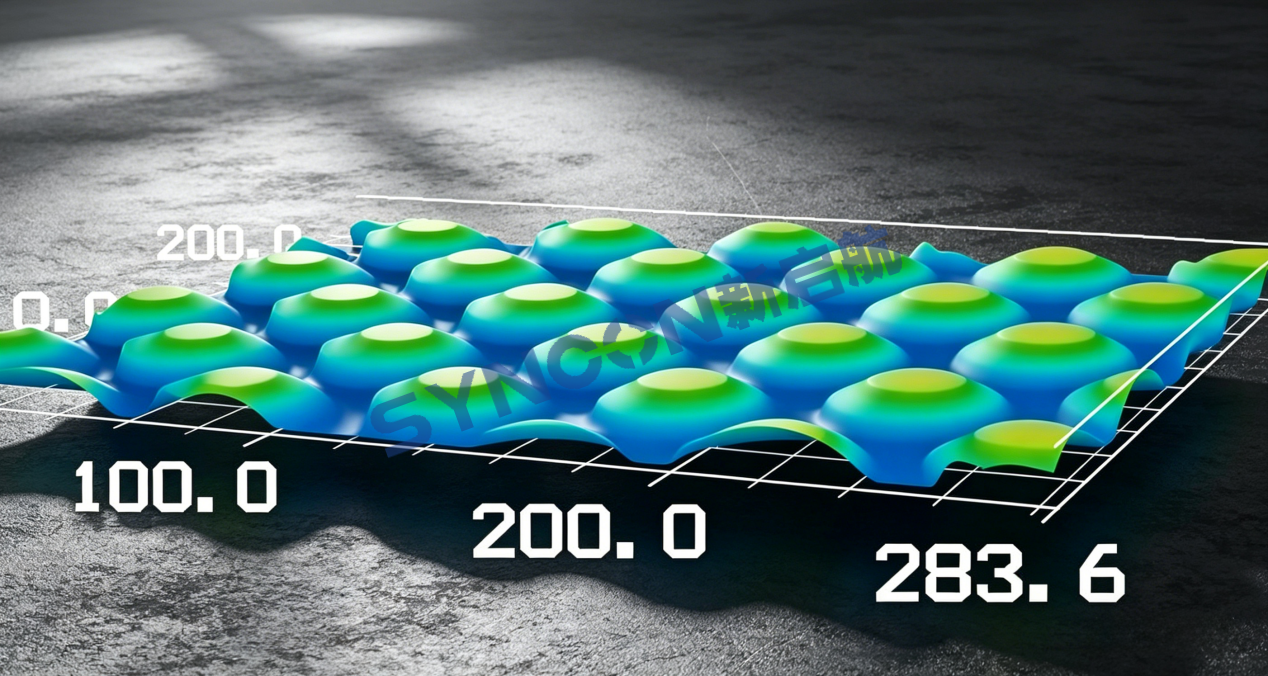

(图示为实测微透镜效果图,精准还原微透镜形貌,为微透镜加工精度检测提供可靠依据)
特色能力2:上下平面平行度测量,拓展检测场景
采用独特光路设计,可实现非/透明产品的厚度和平面平行度测量,适配多层玻璃等光学组件的测量需求,进一步拓展微透镜相关光学部件的检测场景,提升测量通用性。
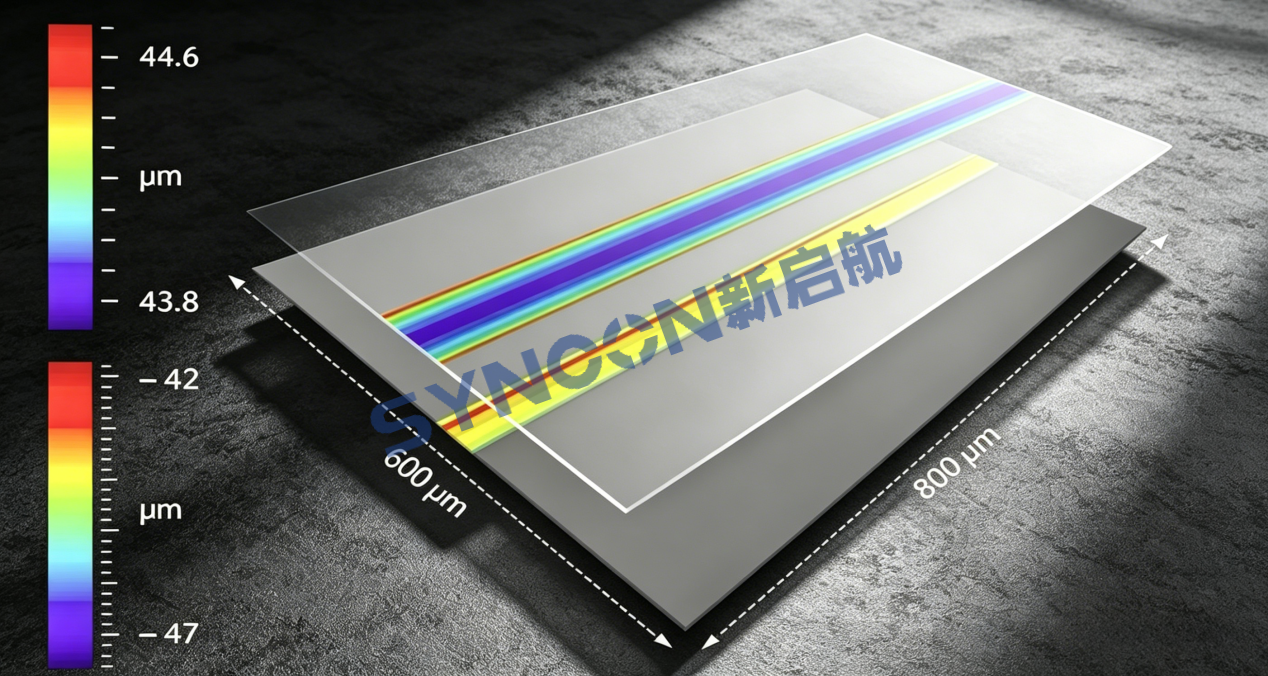
(图示为新启航多层玻璃厚度测量,精准获取厚度数据,保障光学组件装配精度)
新启航半导体——专业提供综合光学3D测量解决方案,深耕微透镜及光学元件检测领域,助力光学产业高质量发展!